KLA Candela光学表面缺陷分析仪(OSA)可对半导体及光电子材料进行先进的表面检测。Candela系列既能够检测Si、砷化镓、磷化铟等不透明基板,又能对SiC、GaN、蓝宝石和玻璃等透明材料进行检测,成为其制程中品质管理及良率改善的有力工具。
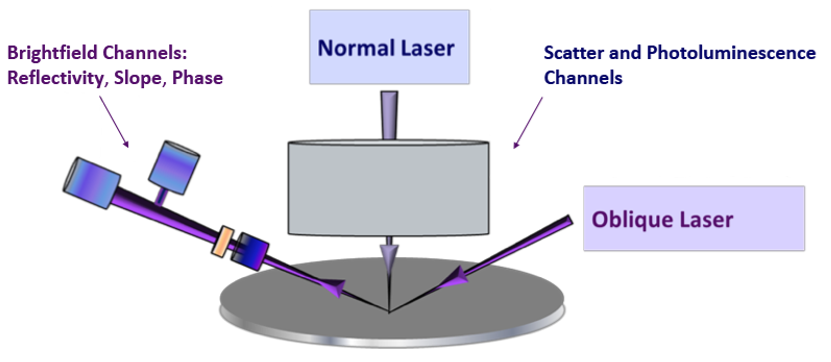
Candela系列采用光学表面分析(OSA)专用技术,可同时测量散射强度、形状变化、表面反射率和相位转移,为特征缺陷(DOI)进行自动侦测与分类。OSA检测技术结合散射测量、椭圆偏光、反射测量与光学形状分析等基本原理,以非破环性方式对Wafer表面的残留异物,表面与表面下缺陷,形状变化和薄膜厚度的均匀性进行检测。Candela系列拥有良好的灵敏度,使用于新产品开发和生产管控,是一套较为具成本效益的解决方案。
二、 功能
主要功能
1. 缺陷检测与分类
2. 缺陷分析
3. 薄膜厚度测量
4. 表面粗糙度测量
5. 薄膜应力检测
技术特点
1. 单次扫描中结合四种光学检测方法的单机解决方案,可实现高效的自动化缺陷检测与分离;
2. 对LED材料的缺陷进行自动检测,从而增强衬底的质量管控,迅速确定造成缺陷的根本原因并改进MOCVD品质管控能力;
3. 满足多种工业要求,包括高亮度发光二较为管(HBLED),高功率射频电子器件,透明玻璃基板等技术;
4. 在多个半导体材料系统中能更灵敏的检测影响产品良率的缺陷。
5. 自动缺陷分类功能(Auto Defect Classification)
(Particle, Scratch, Pit, Bump, and Stain Detection)
6. 自动生成缺陷mapping。
技术能力
1. 检测缺陷尺寸>0.3μm;
2. 大样品尺寸:8 inch Wafer;
3. 超过30种DOI的缺陷分类。
三、应用案例
1. 透明/非透明材质表面缺陷检测

2. MOCVD外延生长成膜缺陷管控

3. PR膜厚均一性评价
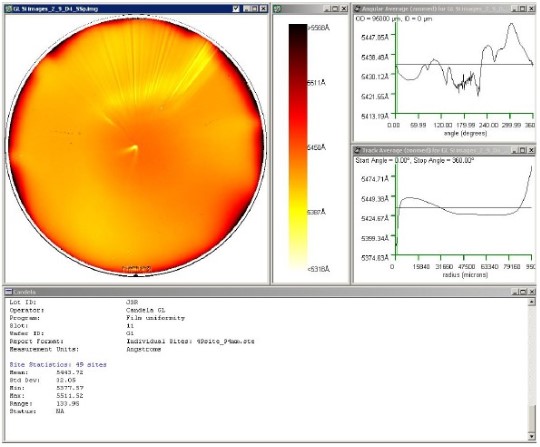
4. Clean制程清洗效果评价
5. Wafer在CMP后表面缺陷分析






