高精度探针针尖变量的亚埃米级表面粗糙度测量,晶圆的表面粗糙度对于确定半导体器件的性能是至关重要的,对于先进的元件制造商,芯片制造商和晶圆供应商都要求对晶圆商超平坦表面进行更精确的粗糙度控制,通过提供低于0.5埃 的业界低噪音,并将与其真正的非接触式是模式相结合,Park NX-Wafer能够可靠地获得具有小针尖变量的亚埃米级粗糙度测量,Park的串扰消除还允许非常平坦的正交XY扫描,不会有背景曲率,及时在平坦的表面上,也不需要过多考虑扫描位置,速率和大小,这使得其非常精确和可重复地对微米级粗糙度到长范围不平整表面进行测量。帕克的智能ADR技术提供全自动的缺陷检测和识别,使得关键的在线过程能够通过高分辨3D成像对缺陷类型进行分类并找出他们的来源,智能ADR专门为半导体工业设计提供先进的缺陷检测解决方案,具有自动目标定位,且不需要经常损坏样品的密集参考标记,与传统的缺陷检测方法相比,智能ADR过程提高了生产率,此外,帕克具有创造性True-Contact模式AFM技术,使得新ADR有能力提高20倍的更长的探针寿命。
工业领先的低噪声帕克原子力显微镜于长距离滑动台相结合,成为用于化学机械抛光计量的原子力轮廓仪,新的低噪声AFP为局部和全面均匀性测量提供了非常平坦的轮廓扫描,具有好的轮廓扫描精度和市场可重复性,这保证在宽范围的轮廓量程上没有非线性或高噪声背景去除的高精度测量。

主要技术特点
200 mm电动XY平台 | 300 mm电动XY平台 | 电动Z平台 |
行程可达275mm x 200mm, 0.5 μm分辨率 | 行程可达400 mm x 300 mm, 0.5μm分辨率 | 25 mm Z行程距离 0.08μm 分辨率 |
电动聚焦平台 | 样品厚度 | COGNEX图像识别 |
8mm 行程Z轴光学距离 | 厚至 20mm | 图像校正分辨率1/4 pixel |
200mm 系统 | 300mm 系统 | 设备需求环境 |
2732mm x1100mm x 2400 mm 大约2110kg 操作员空间:3300mm x 1950mm | 3486mm x 1450 mm x 2400 mm 大约2950 kg 操作员空间: 4770mm x 3050 mm | 室温10 ℃~40 ℃ 操作18 ℃~24 ℃ 湿度 30%~60% |
主要功能
1.晶圆和基底的自动缺陷检测
新的300mm光片ADR提供了从缺陷映射的坐标转换和校正缺陷的测量和放大扫描成像的全自动缺陷复查过程,不需要样品晶圆做任
何的标记,
2.亚埃米级表面粗糙度控制
通过在整个晶圆区域提供低于0.5埃的业界低噪音下线,可以对平坦的基底和晶圆进行精确,可重复和可再现的亚埃米级粗
糙度测量,并小化针尖的变量,即使对扫描尺寸达到100μm x 100 μm的远距离波长,也能够获得非常精确和可重复的表面测量
3.CMP进行表征的长范围轮廓扫描
Park NX-Wafer 实现了先进的CMP测量,包括凹陷、侵蚀和边缘过度侵蚀(EOE)的局部和局部的平坦度测量。
应用
线宽测量
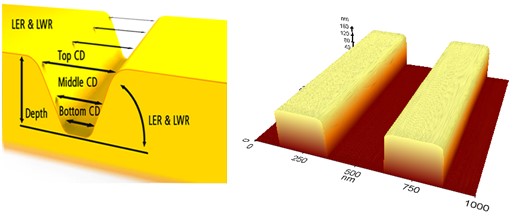
光滑材料表面粗糙度测量

晶圆缺陷自动检测应用

相关文献
Ardavan Zandiatashbar; et al.“Automated AFM for small-scale and large-scale surface profiling in CMP applications” Proc. SPIE 10585, Metrology, Inspection, and Process Control for Microlithography XXXII, 105852U (13 March 2018)






