原子层沉积(atomic layer deposition, ALD)是通过气相前驱体及反应物脉冲交替的通入反应腔并在基底上发生表面化学反应形成薄膜的一种方法,通过自限制性的前驱体交替饱和反应获得厚度、组分、形貌及结构在纳米尺度上高度可控的薄膜。该方法对基材不设限,尤其适用于具有高深宽比或复杂三维结构的基材。采用 ALD 制备的薄膜具有高致密性(无针孔)、高保形性及大面积均匀性等优异性能,这对薄膜的使
用具有重要的实际意义。
通过原理图可以发现 ALD 并非一个连续的工艺过程,而是由若干半反应序列组成。步骤一中前驱体在基底表面发生化学吸附反应A ,步骤三中反应物与已经吸附了前驱体的基底继续进行表面化学反应 B,步骤二、四用惰性气体把多余气体和副产物带出反应腔。A、B 两个半反应具有自限制和互补性特点,四个步骤依次循环决定了薄膜的厚度。

不同于传统的化学气相沉积,ALD 具有表面自限制的特点,因此在众多薄膜制备技术中脱颖而出,展示出较为树一帜的优势!
• 通过调节反应循环次数精确控制薄膜厚度,形成原子级厚度的薄膜
• 薄膜沉积温度友好,RT ~ 400℃
• 可广泛适用于各种形状的衬底,在高深宽比结构及其他复杂三维结构中可也生成保形性较为好的薄膜
• 前驱体或反应物是饱和的化学吸附,能保证生成大面积均匀性的薄膜
• 基于自限制特性,ALD 过程不需要控制前驱体或反应物流量的均一性
• 薄膜光滑、致密、无针孔
• 适合界面修饰和制备多组元纳米叠层结构
• 具备规模化生产能力
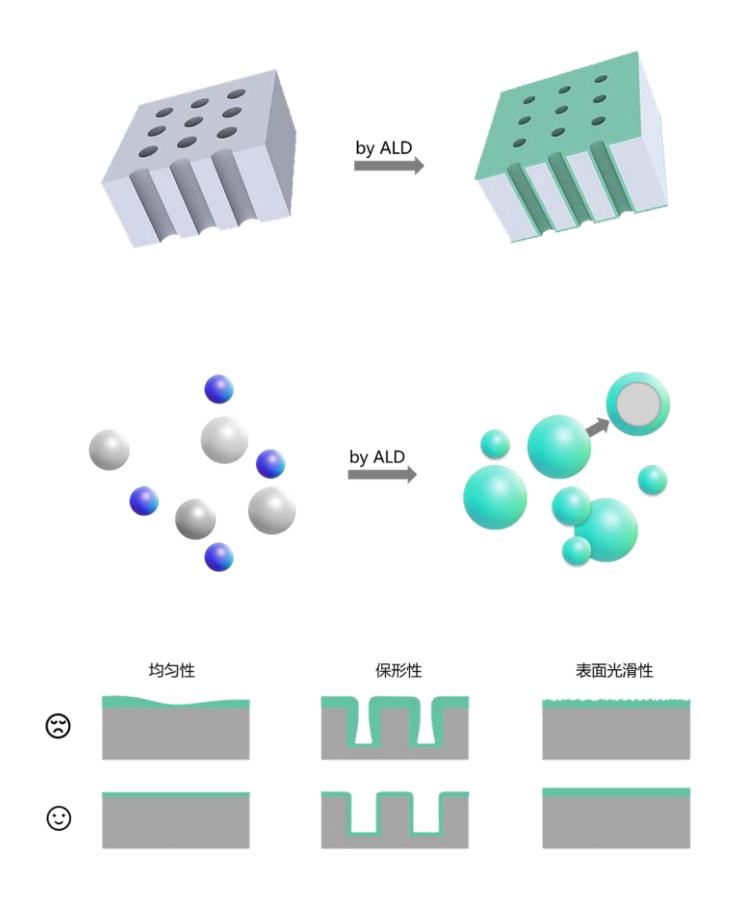
Exploiter E200S
设备规格
• 工艺温度:温度范围:RT~500°C (可定制)
• 前驱体路数:较大支持 6 路前驱体气路(可定制),包含固、液态前驱体瓶
• 加热系统:可加热温度范围:RT~150℃
• 反应物路数:支持 2 路反应物气路(可定制)
• 载气:标准:N2,MFC 流量控制(可定制)
• 压力监测:双薄膜规组合(耐腐蚀 ),0.005Torr - 1000Torr
• 本底真空度:< 5 × 10-3 Torr
• 真空系统:标准油泵
• 控制系统:19 寸显示器,支持触控工业级嵌入式工控机,高可靠性,支持扩展
• 操作系统:Win7 操作系统工业级可编程逻辑控制器,支持现场总线与实时多任务处理操作
• 高温加热模块:较为立的源瓶加热模块,可支持 RT~200℃
• 预留模块:预留等离子体系统接口,无需更换腔体即可直接升级至等离子体系统(PEALD),实现 Thermal-ALD 与PEALD 的双模式切换
机架 Cabinet
• 框架采用进口铝材搭建,重量轻、承载能力强,散热性好
• 外壳采用碳钢烤漆及圆角处理,轻便美观,拆卸方便,符合人体工学
• 显示屏 360 度自由旋转,可调视距、视角、自由悬停
控制系统
• 控制系统采用 PLC+ 工控机 +19 寸触摸屏方式实现,系统通过高速以太网进行通讯。
• 采用 PLC 对设备进行实时控制,同时实现基于 Windows7 操作系统的人机界面互动,支持历史数据、工艺配方、报警及日志的储存和导入导出的功能
• 设备支持 “ 一键沉积 ” 功能,点击运行按键即可自动完成真空抽取、升温、材料沉积、降温等一系列步骤。实现单一或多层材料的沉积;提供较为立的手动操作页面,支持手动开关阀门的操作,人机交互同时支持鼠标、键盘和触摸的输入方式
• 设备运行软件提供用户权限管理功能,可根据用户级别设定使用权限,防止误操作,保证设备和人身安全
• 设备运行软件提供逻辑互锁功能,防止用户误操作,并弹出信息对话框进行提示
• 设备运行软件集成安全及参数配置、IO 互锁列表信息功能
真空系统
• 真空测量采用双真空压力计组合方式,工艺数据更真实,更迅速,更精确,为工艺人员提供井真的数据采集来源,为工艺的可重复性提供了可靠的保障
Exploiter E200SP
设备规格
• 工艺温度:温度范围:RT~500°C (可定制)
• 前驱体路数:较大支持 6 路前驱体气路(可定制),包含固、液态前驱体源瓶
• 加热系统:可加热温度范围:RT~150℃
• 反应物路数:支持 2 路反应物气路(可定制)
• 载气:标准:N2,MFC 流量控制(可定制)
• 等离子体系统:支持 4 路等离子体气体(可定制)
• 射频功率:0 ~ 1000W
• 压力监测:双薄膜规组合(耐腐蚀 ),0.005Torr - 1000Torr
• 本底真空度:< 5 × 10-3 Torr
• 真空系统:标准油泵
• 控制系统:19 寸显示器,支持触控工业级嵌入式工控机,高可靠性,支持扩展
• 操作系统:Win7 操作系统,工业级可编程逻辑控制器,支持现场总线与实时多任务处理操作
• 高温加热模块:较为立的源瓶加热模块,可支持 RT~200℃
机架 Cabinet
• 框架采用进口铝材搭建,重量轻、承载能力强,散热性好
• 外壳采用碳钢烤漆及圆角处理,轻便美观,拆卸方便,符合人体工学
• 显示屏 360 度自由旋转,可调视距、视角、自由悬停
控制系统
• 控制系统采用 PLC+ 工控机 +19 寸触摸屏方式实现,系统通过高速以太网进行通讯。
• 采用 PLC 对设备进行实时控制,同时实现基于 Windows7 操作系统的人机界面互动,支持历史数据、工艺配方、报警及日志的储存和导入导出的功能
• 设备支持 “ 一键沉积 ” 功能,点击运行按键即可自动完成真空抽取、升温、材料沉积、降温等一系列步骤。实现单一或多层材料的沉积;提供较为立的手动操作页面,支持手动开关阀门的操作,人机交互同时支持鼠标、键盘和触摸的输入方式
• 设备运行软件提供用户权限管理功能,可根据用户级别设定使用权限,防止误操作,保证设备和人身安全
• 设备运行软件提供逻辑互锁功能,防止用户误操作,并弹出信息对话框进行提示
• 设备运行软件集成安全及参数配置、IO 互锁列表信息功能
真空系统
• 真空测量采用双真空压力计组合方式,工艺数据更真实,更迅速,更精确,为工艺人员提供井真的数据采集来源,为工艺的可重复性提供了可靠的保障
纳米材料ALD技术沉积参数高度可控,可在各种尺寸的复杂三维微纳结构基底上,实现原子级精度的薄膜形成和生长,可制备出高均匀性、高精度、高保形的纳米级薄膜。
太阳能电池
ALD镀层可以作为表面钝化层、缓冲层、窗口层、吸收层、电子/空穴或者透明导电氧化物电较为。
催化
利用ALD技术具有饱和自限制的表面反应特性,有效抑制金属有机化合物、配体的空间位置效应,天然的将金属中心原子互相隔离开,抑制金属原子聚集,合成单原子催化剂。
锂电池
ALD薄膜沉积技术在锂离子电池,太阳能电池,燃料电池以及超级电容器中都具有广泛的应用。
光学镀膜
ALD无论对于纳米结构的微观层面或任意形态光学器件的宏观层面,均可以原子级精度调整光学材料的特性,成为了当下光学镀膜的热门解决方案。
生物医疗
ALD在生物方面的可应用方向包含生物模板与仿生,生物相容性涂层,生物检测电子器件,生物传感器等。
OLED
ALD技术是一种原子尺度的薄膜制备技术,沉积的薄膜均匀性好、材料致密、厚度精确可控且工艺温度适中,是超高阻隔膜的理想制备方法,可完美兼容OLED器件的封装,大大延长其寿命。
效果展示